| エリプソメトリとは 基板上に薄膜があります。この薄膜から反射してくる光は、干渉の結果、入射光とは位相振幅強度が異なっています。
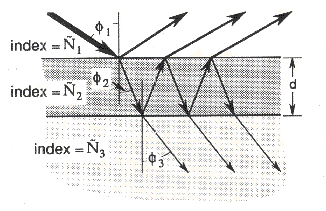
Fig. 1
After H.G. Tompkins


直線偏光を入射すると、反射光は楕円偏光になります。エリプソメトリでは楕円偏光の位相角Δと、楕円の振幅強度比から求められる正接Ψを測定し、薄膜の膜厚及び複素屈折率を求めます。
注意深く測定し正しい解析・解釈をおこなえば、極めて有益な情報がえられます。たとえば、最表面の単原子層の挙動をモニターすることも可能です。

Fig 2
After H.G. Tompkins
tan(PSI)=|Rp|/|Rs|
tan(PSI)exp(iDEL)=Rp/Rs
残念ながら、測定されたΨおよびΔの値から膜厚dと屈折率Nを解析的に求めることはできません。逆に、dとNからはΨとΔを計算で求めることができます。そこで、様々なdとNについてΨとΔを計算した表をやチャートを用意しておけば、dとNを決定することができます。(市販のエリプソメーターの付属解析ソフトではこの作業を最小2乗法等をもちいて行っています。)
このソフトの意義
このスプレッドシートは、膜厚d、膜屈折率N、基板屈折率Ns、入射角φ、入射波長λを与えてΨとΔを計算します。ΨとΔの測定値からからdやNを求める場合には、ΨとΔの表を作って、測定値に合うように“追いこんで”いきます。
エリプソメトリーの原理を学ぶのに役立ちます。また、市販のエリプソメーターから得られるデータの意味の理解を助けます。
エリプソメーターが出力する測定結果をチェックしたり、より高精度な測定をする条件について検討することができます。
エリプソメーターが出力する測定結果は常に正しいとは限りません。
エリプソメトリは原理上、解析的に膜厚dと屈折率Nを求めることができません。誤った光学モデルが用いられたり、エリプソメーター付属ソフトでの計算アルゴリズムの不具合・近似計算精度の限界などの理由から、異常なdやNの値が得られることもあります。
光学的な測定誤差や測定限界も考えられます。
このシートで再計算して、測定結果を振り返ってみましょう。
光をつかった薄膜の物性測定実験の計画やデータの整理にも役立つでしょう。
注意と使い方
このワークシートは、Microsoft
Excel 97のBookタイプで作製しました。その他のバージョンでは動作しない可能性があります。アドインの「解析」ツールが必要です。
計算結果はExcelの内部まるめ誤差を含んでいます。通常のほとんどの用途では問題になりませんが、極めて精密な解析には適さない可能性があります。
このワークシートおよび内部に記述された計算式の著作権は作者(近藤英一)に帰属します。ワークシートおよび内部に記述された計算式の使用、再配布、改変は非営利の学術・教育目的および非営利の私的利用に限り自由かつ無償です。ただし、出版物への掲載・添付、大規模な形態での配布には非営利であっても事前の許諾が必要です。学術・教育・私的利用以外の目的および営利目的での利用に関しては作者の事前許諾が必要です。このワークシートは作者自身の使用を目的として作製されたもので、動作および計算結果について保証するものではありません。本ワークシートおよびその計算結果を利用して発生したいかなる不利益に対しても、作者は責任を負いません。
ご感想、ご意見、ご要望、ご指摘、使用レポートをお待ちしています。[MAIL]
三層計算用シートもつくってあります。文書を準備していないので、お問い合わせください。【追記】配布は原則として中止することにしました。大変失礼な依頼ばかりで,手間を割いて送るのがばかばしくなりました。お礼のメールくらいは普通だしませんか?
ネットスケープでダウンロードできないとのご指摘をいただいております。こちらのzipファイルをお試しください。
Special thanks to T. Yumii and H.G. Tompkins
1.基本ワークシート
ellips.xlt zipファイル
4枚のワークシート "Single
Layer"、"Substrate Calculation"、"Effective
Medium"、"Optical Properties"から成っています。単層薄膜および基板の計算ができます。
使用に先立ち、Excelの“ツール”→“アドイン”メニューから「分析ツール」を選択してください。
1)Single Layer
このスプレッドシートでは、単層膜の厚さd、膜屈折率N、基板屈折率Ns、入射角φ、入射波長λを与えて、Ψ、Δ、膜厚周期を計算します。セルA7~H7,
J7に各数値を入力すると、AB7, AC7, I7に計算結果が表示されます。
セルK7~AA7は計算用で、セル列幅を0に設定しています。セルの内容をコピーする場合には、行全体かA7~AC7全てのセルをコピーしてください。またオートフィルを行う場合にはA7~AC7をドラッグしたください。
| 入力項目 |
セル |
|
| n1 |
A7 |
環境媒質の屈性率実数部 (真空及び空気の場合は1) |
| k1 |
B7 |
環境媒質の屈性率虚数部。負号をつけて入力のこと。.(真空及び空気の場合は0) |
| n2 |
C7 |
膜の屈性率実数部 |
| k2 |
D7 |
膜の屈性率虚数部。負号をつけて入力のこと。 |
| n3 |
E7 |
基板の屈性率実数部 |
| k3 |
F7 |
基板の屈性率虚数部。負号をつけて入力のこと。 |
| Angle (Phai1) |
G7 |
入射角(°) |
| L |
H7 |
入射光波長(Å) |
| Film Thickness |
J7 |
膜厚(Å) |
| |
|
|
| 出力項目 |
|
|
| DELTA |
AB7 |
Δ(°) |
| PSI |
AC7 |
Ψ(°) |
| Period |
I7 |
等価な光学特性となる膜厚周期(Å) |
| |
|
|
2)Substrate Calculation
基板自体の複素屈折率をΔ、Ψから計算します(上記薄膜計算例と異なり、基板の複素屈折率はΔ、Ψから解析的に求めることができます)。もし、
薄膜が存在している基板を測定した場合には、膜を含むみかけの屈折率が得られることになります。
| 入力項目 |
セル |
|
| n1 |
A6 |
環境媒質の屈性率実数部 (真空及び空気の場合は1) |
| k1 |
B6 |
使用しない |
| DELTA |
C6 |
Δ(°) |
| PSI |
D6 |
Ψ(°) |
| Angle (Phai1) |
E6 |
入射角(°) |
| |
|
|
| 出力項目 |
|
|
| n3 |
O6 |
基板の屈性率実数部 |
| k3 |
P6 |
基板の屈性率虚数部 |
3)Effective Medium Approximation
2種類の混合物の光学定数をBruggmanの有効媒質近似によって計算します。たとえば、多孔体や、細かい凹凸のある表面層はホストの固体+空隙としてモデル化できます。また膜中に微粒子が分散しているような場合にも適用できます。
ただし、分散体(空隙、凹凸)のサイズは光の波長よりも小さい必要があります。
| 入力項目 |
セル |
|
| n1 |
A7 |
媒質1の屈性率実数部 |
| k1 |
B7 |
媒質1の屈性率虚数部 |
| Medium 1 vol% |
C7 |
媒質1の体積比(%) |
| n2 |
D7 |
媒質2の屈性率実数部 |
| k2 |
E7 |
媒質2の屈性率虚数部 |
| |
|
|
| 出力項目 |
|
|
| n |
Q7 |
基板の屈性率実数部 |
| k |
R7 |
基板の屈性率虚数部 |
4)Optical
Properiteis
物質の光学定数表です。
2.計算例
1)Si基板上の透明膜 ellips2.xls zipファイル
Si基板上の透明膜(k2=0)の膜厚を変えた場合のΔとΨをプロットしています。膜は、n2=1.2,
1.46 (SiO2), 1.8の3種類について計算しています。
Δ、Ψの測定値から膜厚や屈折率を求める場合には、もっと細かく膜厚・屈折率を変えて計算した表やグラフを用意し、適宜補間して決定します。
膜厚が薄い場合、あるいは周期膜厚に近い場合(Ψ~10°)には、Δ・Ψの屈折率依存性が小さいことがわかります。従って、この場合には屈折率の誤差が大きくなる可能性があります。一方Ψの値が大きい場合、Δ・Ψの屈折率依存性が大きいので、精度が高くなります。
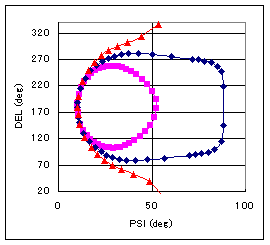
Fig. 3
2)Si基板上の吸収膜 ellips3.xls zipファイル
Si基板上に堆積したW薄膜について、膜厚を20Åづつ変えてプロットしています。波長は6330Åです。
Si(Ψ=10.3、Δ=179.1)から出発し、W(Ψ=24.1、Δ=130.6)に収束します。膜厚が薄い場合にはSiに近い“色”をしていますが、膜厚が厚くなるとWの“色”に近づきます。膜に吸収がある(k
< 0)ため、透明膜のように周期性を持ちません。
約200Åくらいまでは光を透過することがわかります。
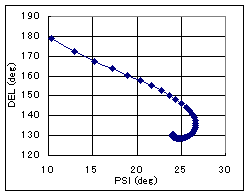
Fig. 4
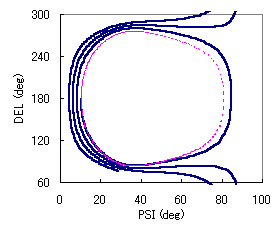
Fig. 5
(1)のN=1.8の透明膜のデータと重ねてみました。軌道が何回も交わっていることがわかります。
たとえばΨ=16.9°、Δ=105.7°のときの膜厚は透明膜が285,
2345, 4410, ...
Åなのですが、吸収膜では3420Åです。このように、光学モデルによって結果はずいぶん異なってしまいます。エリプソメーターの測定結果の解釈に注意であることがわかります。また、厚さの異なった膜を用意して測定すれば誤った解釈を防ぐことができることもわかります。
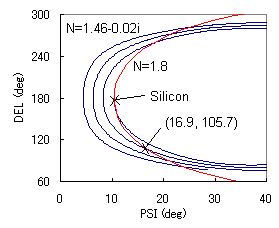
Fig. 6
3)ΔとΨの波長依存性 ellips4.xls zipファイル
Si基板上に堆積したSiO2薄膜(膜厚3000Å)について、波長を変えてプロットしています。
このような測定を分光エリプソメトリといいます。単波長測定ではできない高度な解析(正確な膜厚や屈折率の測定、多層膜の解析、膜にボイドなどの構造がある場合の解析)を行うことができます。
解析では、適当な光学モデルをつくって、下図と同様のグラフをプロットし、実測定結果との比較を行います。本ワークシートでもSi上の膜については実用上十分な解析を行うことができるでしょう。
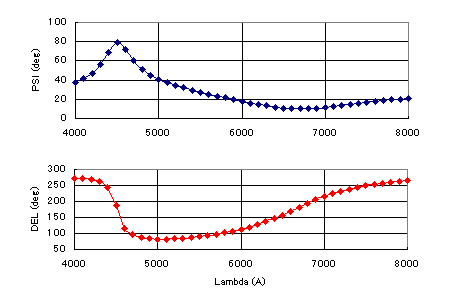
Fig. 7
|